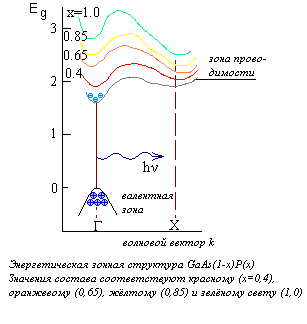
Светодиодом, или излучающим диодом, называют полупроводниковый прибор (p-n переход), излучающий кванты света при протекании через него прямого тока.
По характеристике излучения излучающие диоды можно разделить на две группы: с излучением в видимой части спектра (светодиода) и инфракрасной - диоды ИК-излучения.
Светодиоды выпускаются красного (GaP : ZnO, GaAs0,6P0,4), оранжевого (GaAs0,35P0,65), зеленого (GaP), желтого (GaAs0,14P0,86), голубого (GaAs - ErYb, SiC), фиолетового (GaN) цветов свечения, а также с переменным цветом свечения. Последние имеют два электронно-дырочных перехода. Общий свет свечения зависит от соотношения токов, протекающих через эти переходы. Светодиоды чаще всего используют как индикаторные устройства. Поскольку глаз чувствителен только к свету с энергией hv~1.8 эВ (~0.7 мкм), то полупроводники, которые могут быть использованы для создания светодиодов видимого диапазона, должны иметь ширину запрещённой зоны больше этого значения. На практике наибольший интерес представляет GaAs(1-x)Px.
На рис.1 приведена зависимость запрещенной от волнового вектора для нескольких значений х, из которой следует, что зона проводимости имеет два минимума. Те минимумы, которые расположены в точке Г, являются прямыми, тогда как другие, расположенные на оси х, непрямые.
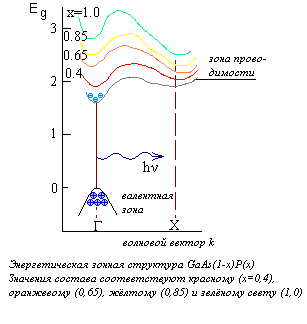
Рис.1
Принцип действия светодиода основан на излучательной рекомбинации инжектированных носителей в прямосмещенном p-n переходе (рис. 2).
Рис.2
где Lp - диффузионная длина (~250 мкм).
Электроны в прямом минимуме зоны проводимости и дырки в максимуме валентной зоны обладают одинаковыми квазиимпульсами; электроны в непрямом минимуме имеют другое значениеквази импульса. Для таких прямозонных полупроводников, как GaAs(1-x)Px (x < 0.45) квазиимпульс при межзонных переходах сохраняется, поэтому эти переходы характеризуются высокой степенью вероятности. При этом энергия фотона приблизительно равна ширине запрещённой зоны полупроводника. В прямозонных материалах процесс излучательной рекомбинации является доминирующим. В то же время для GaAs(1-x)Px при х > 0.45 и GaP, у которых запрещённая зона не прямая, вероятность междузонных переходов черезвычайно мала, поскольку в этом случае для преобразования квазиимпульса при переходе требуется участие фононов или других факторах рассеяния. Поэтому для усиления излучательных процессов в непрямозонных полупроводниках, таких, например, как GaP, специально создаются рекомбинационные центры. Эффективные центры излучательноц рекомбинации в GaAs(1-x)Px могут быть созданы путём внедрения специальных примесей, например азота. Азот, внедрённый в полупроводник, замещает атомы фосфора в узлах решётки. Азот и фосфор имеют одинаковую внешнюю электронную структуру (оба относятся к V группе элементов периодической системы), а структуры их внутренних оболочек сильно различаются. Это приводит к возникновению вблизи зоны проводимости электронного уровня захвата. Полученный таким образом рекомбинационный центр называется изоэлектронным центром. В нормальном состоянии изоэлектронные центры нейтральны. В материале p-типа инжектированный электрон сначала захватывается на центр. Заряженный отрицательно центр затем захватывает дырку из валентной зоны, формируя связанный экситон. Последующая аннигиляция этой электронно-дырочной пары приводит к рождению фотона с энергией, примерно равной разности между шириной запрещённой зоны и энергией связи центра. Так как захваченный электрон сильно локализован на центре, его импульс рассеивается. Таким образом обеспечивается преобразование квазиимпульса, вследствие чего вероятность прямого перехода существенно возрастает. В непрямозонных материалах, таких, как GaP, описанный механизм излучательной рекомбинации является преобладающим.
Среди светодиодных структур основной является структура с плоской геометрией (см. рис.). Обычно прямозонные светодиоды (красное излучение) формируются на подложках GaAs (а), тогда как непрямозонные (оранжевое, жёлтое и зелёное излучения) - на подложках GaP (б). При использовании подложки GaAs на неё наращивается переходный слой GaAs(1-x)Px переменного состава с х, изменяющимся в пределах 0-0.4, а затем слой GaAs(1-x)Px с постоянным составом.
|
Переходная область ограничивает образование безызлучательных центров, обусловленных различием решёток. Фотоны, генерируемые в области перехода, испускаются во всех направлениях, однако наблюдателя достигает лишь та их часть, которая проходит через поверхность. Уменьшение количества излучаемых светодиодом фотонов обусловлено поглощением в материале светодиода, потерями за счёт отражения и потерями за счёт полного внутреннего отражения. Потери, связанные с поглощением, весьма существенны в светодиодах на подложках GaAs (а), т.к. в этом случае подложка поглощает примерно 85% фотонов, излучаемых переходом. В светодиодах на подложках GaP (б) поглощение составляет ~25%, и эффективность излучения может быть существенно увеличена.
Полная эффективность преобразования электрического сигнала в оптический даётся следующим выражением:

На рис. 3 показаны поперечные разрезы других светодиодов, которые имеют параболическую, полусферическую и усечённо сферическую геометрию.
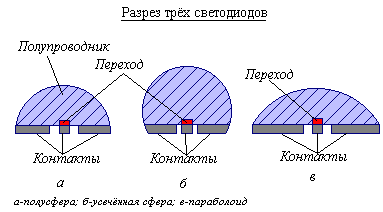
Рис.3
Основное отличие этих трёх структур от структуры с плоской геометрией состоит в том, что телесный угол для них равен 1. Таким образом, отношение эффективностей равно

Это означает, что для структур на GaP c n=3.45 при данной геометрии можно ожидать увеличения эффективности на порядок.
Областями применения диодов ИК-излучения являются оптронные устройства коммутации, оптические линии связи, системы дистанционного управления.
Наиболее распространённый в настоящее время инфракрасный источник - это светодиод на основе GaAs. Он обладает наибольшей эффективностью электролюминесценции в основном благодаря тому, что среди всех прямозонных полупроводников GaAs является технологически наиболее освоенным. Для изготовления инфракрасных светодиодов используются многие другие полупроводники,имеющие запрещённую зону шириной менее 1,5 эВ. К ним относятся твёрдые растворы, в состав которых входят три или четыре элемента III и V групп периодической системы.
Светодиоды по сравнению с лазерами имеют как преимущества, так и недостатки. К последним относятся меньшая яркость, более низкие частоты модуляции и большая спектральна ширина линии излучения, типичное значение которой составляет 100-500 ангстрем, тогда как лазеры характеризуются шириной линии 0,1-1 ангстрем. Различают два основных типа светодиодов, обеспечивающих ввод излучения в оптические волокна малого диаметра: светодиоды с излучающей поверхностью (рис.4) и с излучающей гранью (рис.5).
Рис. 4 |
Рис. 5 |
Важным параметром, которыйдолжен учитываться при конструировании светодиодов для оптических систем связи, является диапазон рабочих частот. При внешнем возбуждении скорость полной излучательной рекомбинации определяется выражением: Rr = Bnp
где В-константа излучательной рекомбинации, равная G/n0p0 (G-скорость полной термической генерации).
При достаточно низких
уровнях возбуждения, таких, что в
материале р-типа р примерно равно р0,
время жизни излучательной
рекомбинации становится равным: ![]() , а для
материала n-типа, когда n примерно
равно n0:
, а для
материала n-типа, когда n примерно
равно n0: ![]() .
.
Предельная частота
светодиода ![]() .
.
Экспериментально показано, что предельная частота возрастает с концентрацией р0. Для достижения высоких значений f необходимо уменьшать толщину рекомбинационной области и увеличивать концентрацию носителей.
Общие замечания.
Полуповодниковые лазеры, подобно другим лазерам (таким, как рубиновый лазер или же лазер на смеси He - Ne), испускают излучение, когерентное в пространстве и во времени. Это означает, что излучение лазера высоко монохроматично (имеет узкую полосу спектра) и создает строго направленный луч света. Вместе с тем по ряду важных характеристик полупроводниковык лазеры существенно отличаются от лазеров других типов.
1. В обычных
лазерах квантовые переходы
происходят между дискретными
энергетическими уровнями, тогда
как в полупроводниковых лазерах
переходы обусловлены зонной
структурой материала.
2.
Полупроводниковые лазеры имеют
очень малые размеры (~0,1 мм в длину),
и так как активная область в них
очень узкая (~1 мкм и меньше),
расхождение лазерного луча
значительно больше, чем у обычного
лазера.
3.
Пространственные и спектральные
характеристики излучения
полупроводникового лазера сильно
зависит от свойств материала, из
которого сделан переход (таких
свойств, как структура запрещенной
зоны и коэффициент преломления).
4. В лазере с
р-n переходом лазерное излучение
возникает непосредственно под
действием тока, протекающего через
прямосмещенный диод. В результате
система очень эффективна,
поскольку позволяет легко
осуществлять модуляцию излучения
за счет модуляции тока. Так как
полупроводниковые лазеры
характеризуются очень малыми
временами стимулированного
излучения, модуляция может
проводиться на высоких частотах.
В качестве материалов, используемых в полупроводниковых лазерах применяются полупроводники с прямой запрещенной зоной. Это обусловлено тем, что излучательные переходы в прямозонных полупроводниках представляют собой процесс первого порядка и вероятность переходов высока. В полупроводниках с непрямой зоной излучательная рекомбинация выступает как размер второго порядка, так что вероятность излучательных переходов существенно ниже. Кроме того, в непрямозонных полупроводниках при увеличении степени возбуждения потери, связанные с поглощением излучения на инжектированных свободных носителях, возрастают быстрее, чем усиление.
Диапазон длин
волн лазерного излучения
охватывает область спектра от
ультрафиолетовой до инфракрасной.
В интервале длин волн вблизи 0,9 мкм в качестве
источников излучения используется
гетеролазеры на основе GaAs-Al(x)Ga(1-x)As.
Вблизи длины волны 1,3
мкм в ВОЛС волокно имеет низкие
потери (0.6 Дб/км) и слабую дисперсию,
а в окрестности длины волны 1,55 мкм потери
достигают минимального значения (0,2
дБ/км), поэтому в качестве
источников излучения могут
использоваться лазеры на основе Ga(x)In(1-x)As(y)P(1-y)-InP.
Рис.1
Стимулированное излучение. Работа лазера связана с тремя основными процессами, обусловленными переходом носителей: поглощение, спонтанной эмиссии и стимулированным излучением. Расмотрим два энергетических уровня E1 и Е2, один из которых Е1 характеризует основное, а другой Е2 - возбужденное состояние. (рис. 2)
Рис. 2
Любой переход между этими состояниями сопровождается испусканием или поглощением фотона с частотой n12, определяемой из соотношения hn12=E2-E1. При обычных температурах большинство атомов находится в основном состоянии. Эта ситуация нарушается в результате воздействия на систему фотона с энергией, равной hn12. Атом в состоянии E1 поглощает фотон и переходит в возбужденное состояние Е2. Это и составляет процесс поглощения излучения. Возбужденное состояние является нестабильным и через короткий промежуток времени без какого-либо внешнего воздействия атом переходит в основное состояние, испуская фотон с энергией hn12 (спонтанная эмиссия). Время жизни, связанное со спонтанной эмиссией (т.е. среднее время возбужденного состояния), может изменяться в широком диапазоне, обычно в пределах 10-9 - 10-3 с, в зависимости от параметров полупроводника, таких, как структура зон (прямая или не прямая) и плотность рекомбинационных центров. Столкновение фотона, обладающего энергией hn12, с атомом, находящемся в возбужденном состоянии, стимулирует мгновенный переход атома в основное состояние с испусканием фотона с энергией hn12 и фазой, соответствующей фазе падающего излучения (стимулированное излучение).
На рис.
3 показана базовая структура
лазера с p-n переходом. Две боковые
грани структуры скалываются или
полируются перпендикулярно
плоскости перехода. Две други грани
делаются шероховатыми для того,
чтобы исключить излучение в
направлениях, не совпадающих с
главным. Такая структура
называется резонатором
Фабри-Перо. Смещение лазерного
диода в прямом направлении
вызывает протекание тока. Вначале,
при низких значениях тока,
возникает спонтанное излучение,
распостраняющееся во всех
направлениях. При увеличении
смещения ток достигает порогового
значения, при котором создаются
условия для стимулированного
излучения, и р-n переход испускает
монохроматичный строго
направленный луч света.
Рис.3
Для гомоструктур (например для р-n переходов на основе GaAs) пороговая плотность тока быстро увеличивается с ростом температуры. При комнатной температуре типичное значение Jth составляет 5*104 A/см2. Такая большая плотность тока создает серьезные трудности для реализации режима непрерывной генерации при 300К.
С целью уменьшения пороговой плотности тока были реализованы лазеры на гетероструктурах (с одним гетеропереходом - nGaAs-pGaAs-Al(x)Ga(1-x)As; c двумя гетеропереходами - Al(x)Ga(1-x)As-GaAs-Al(x)Ga(1-x)As). В структуре с двумя гетеропереходами носители сосредоточены внутри активной области d, ограниченой с обеих сторон потенциальными барьерами; излучение также ограничено этой областью вследствие скачкообразного уменьшения показателя преломления за ее пределы. Эти ограничения способствуют усилению стимулированного излучения и соответственно уменьшению пороговой плотности тока.
На рис. 4 приведена зависимость Jth от рабочей температуры для трех лазерных структур. Самая слабая зависимость от температуры наблюдается для лазеров на двойных гетероструктурах (ДГ-лазерах). Поскольку Jth в ДГ-лазерах при 300К может достигать значений порядка 103 А/см2 и менее, оказывается возможным реализовать режим непрерывной генерации при комнатной температуре. Благодаря этому лазеры нашли широкое применение в науке и промышленности, в частности в ВОЛС.
Рис. 4
В условиях теплового равновесия в основном состоянии находится больше атомов, чем в возбужденном. Если возникает обратная ситуация, то говорят об инверсной населенности. При взаимодействии фотонов, обладающих энргией hn12, с простой системой (рис.1), в которой уровень Е2 инверсно заселен по отношению к уровню Е1, стимулированная эмиссия будет преобладать над поглощением, и в результате систему будет покидать больше фотонов с энергией hn12, чем входить в нее. Такое явление называется квантовым усилением. Неравенство (ЕFC - EFV) > hn является необходимым для того, чтобы стимулированное излучение преобладало над поглощением (ЕFC - EFV - квазиуровни Ферми).
На рис. 5 приведена зависимость коэффициента усиления от плотности тока, рассчитанная для GaAs. По мере увеличения тока усиление растет до тех пор, пока не достигается порог лазерной генерации, т.е. не создаются условия, при которых световая волна проходит через резонатор без затухания.
Рис. 5
Выражение для пороговой
плотности тока:
где:
g0/J0=5*10-2 см*мкм/А,
J0 = 4,5*103 А *см2 *мкм
Г - коэффициент оптического
ограничения
a - потери на излучения на единице
длины, обусловленные поглощением
на свободных носителях и
рассеянием на дефектах
L - длина резонатора.
R - коэффициент отражения зеркал
резонатора.
d - активный слой
h - квантовая
эффективность.
Низкая пороговая плотность
тока в гетеролазерах
обеспечивается двумя факторами: 1)
ограничением носителей
энергетическими барьерами между
активной областью и слоем
полупроводника с более широкой
запрещенной зоной и 2) оптическим
ограничением за счет резкого
уменьшения показателя преломления
за пределами активной области.
На рис.6 показан полосковый лазер. Мезополосковая структура лазера создается путем травления. После нанесения металлических контактов осуществляется завершающая операция скалывания граней, в результате которй формируется резонатор Фабри-Перо. В такой структуре не надо создавать окисную изоляцию или проводить протонную бомбардировку. Боковое ограничение тока достигается за счет высокого контактного сопротивления между металлом и слаболeгированным p-AlGaAs. Этот лазер имеет низкую пороговую плотность тока, линейную ВАХ и работает в режиме генерации основной поперечной моды с одной продольной модой на длине волны 0,861 мкм.
Рис.6
В настоящее время созданы полупроводниковые лазеры на основе структур со сверхрешеткой. Такие приборы называются гетеролазерами с квантовыми ямами. Изготавливаются на основе стуктуры Al(x)Ga(1-x)As - GaAs методом химического вакуумного осаждения из металлоорганики. Преимущество лазеров с квантовыми ямами состоят в высокой квантовой эффективности, низком пороговом токе(1 мА и менее) и слабой чувствительности к изменениям температуры.
На рис. 7 приведена типичная зависимость мощности ДГ-лазера при возрастании тока от низких значений, характерных для спонтанной эмиссии, до значений, превышающих порог лазерной генерации. На начальном участке, соответствующем спонтанной эмиссии, интенсивность излучения медленно растет с увеличением тока, протекающего через диод, а после возбуждения лазерной генерации резко возрастает.
Рис.7
Режим спонтанной эмиссии, наблюдающейся при низких токах, характеризуется широким спектром излучения (полуширина спектра обычно составляет 100 - 500 А). При возрастании тока до значений, близких к пороговому, спектр излучения становится уже. На рис. 8 приведены спектры для различных значений тока, иллюстрирующие эффект сужения полосы излучения при переходе к режиму лазерной генерации.
Рис.8
При пропускании через лазер импульса тока с амплитудой, достаточной для получения стимулированного излучения, генерация излучения обычно начинается с задержкой, равной нескольким нс. Время задержки связано с временем жизни неосновных носителей.
Деградация лазеров. Деградация инжекционных лазеров обусловлена целым рядом механизмов. Выделяют три основных типа деградации: 1) катастрофическое разрушение; 2) образование дефектов темных линий; 3) постепенная деградация.
Катастрофическое разрушение происходит под действием больших мощностей излучения, приводящих к непрерывному повреждению зеркал лазера вследствие образования на их поверхности ямок и канавок.
Дефекты темных линий представляют собой сетку дислокаций, которые могут формироваться в процессе работы лазера и внедряться внутрь резонатора. Появившись, она может сильно разрастись в течение нескольких часов и вызвать увеличение плотности порогового тока.
Длину волны излучения полупроводникового лазера можно регулировать путем изменения тока диода или температуры теплоотвода, а также с помощью магнитного поля или давления. Такие достоинства полупроводниковых лазеров, как возможность перестройки длины волны узкой линии излучения, высокая стабильность, низкая потребляемая мощность, простота конструкции, открывают широкие перспективы их применения в промышленности и фундаментальных исследованиях, таких как молекулярные и атомные спектроскопы, газовые спектроскопы высокого разрешения и контроль загрязненности атмосферы. Также полупроводниковые лазеры применяются в качестве источников излучения для волоконно-оптических линий связи (ВОЛС).